三星宣布正式推出全新 2.5D 封裝解決方案 H-Cube
 10
10
 拍明
拍明
原標題:三星宣布正式推出全新 2.5D 封裝解決方案 H-Cube
三星宣布正式推出的全新2.5D封裝解決方案H-Cube(Hybrid Substrate Cube,混合基板封裝)是針對高性能計算(HPC)、人工智能(AI)、數據中心和網絡產品等需要高性能和大面積封裝技術的領域而設計的。以下是對該解決方案的詳細解析:
一、技術背景
隨著現代高性能計算、人工智能和網絡處理芯片的規格要求越來越高,需要封裝在一起的芯片數量和面積劇增,帶寬需求也日益增高。這使得大尺寸的封裝變得越來越重要,但同時也帶來了制造上的挑戰。三星推出的H-Cube封裝解決方案正是為了應對這些挑戰而開發的。
二、技術特點
混合基板設計:
H-Cube封裝解決方案通過整合兩種具有不同特點的基板,即精細化的ABF(Ajinomoto Build-up Film,味之素堆積膜)基板和高密度互連(HDI)基板,實現了更大的2.5D封裝。這種混合基板設計能夠有效地解決大面積基板制造難度高、生產效率低的問題。
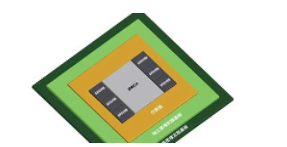
縮小基板尺寸:
三星通過將連接芯片和基板的焊錫球間距縮短35%,成功地縮小了ABF基板的尺寸。同時,在ABF基板下添加HDI基板以確保與系統板的連接,從而實現了更緊湊的封裝結構。
穩定供電和信號傳輸:
三星應用了其專有的信號/電源完整性分析技術,在堆疊多個邏輯芯片和高帶寬內存(HBM)時,能夠穩定地提供電源,并最大限度地減少信號損失或失真。這確保了H-Cube封裝解決方案在高性能應用中的可靠性和穩定性。
三、合作與開發
H-Cube封裝解決方案是三星與三星電機(SEMCO)以及主要的OSAT(組裝和最終檢查承包商)Amkor Technology聯合開發的。這種跨公司的合作模式有助于整合各方資源和技術優勢,共同推動2.5D封裝技術的發展和應用。
四、市場前景
隨著高性能計算、人工智能和網絡市場的不斷擴展,對高性能和大面積封裝技術的需求將持續增長。三星的H-Cube封裝解決方案憑借其先進的技術特點和廣泛的應用前景,有望在這些領域占據重要地位。同時,隨著技術的不斷成熟和成本的降低,H-Cube封裝解決方案的市場競爭力也將進一步增強。
綜上所述,三星宣布正式推出的全新2.5D封裝解決方案H-Cube是一項具有創新性和前瞻性的技術成果。它不僅解決了當前高性能計算、人工智能和網絡產品領域面臨的封裝挑戰,還為未來的技術發展奠定了堅實的基礎。
責任編輯:David
【免責聲明】
1、本文內容、數據、圖表等來源于網絡引用或其他公開資料,版權歸屬原作者、原發表出處。若版權所有方對本文的引用持有異議,請聯系拍明芯城(marketing@iczoom.com),本方將及時處理。
2、本文的引用僅供讀者交流學習使用,不涉及商業目的。
3、本文內容僅代表作者觀點,拍明芯城不對內容的準確性、可靠性或完整性提供明示或暗示的保證。讀者閱讀本文后做出的決定或行為,是基于自主意愿和獨立判斷做出的,請讀者明確相關結果。
4、如需轉載本方擁有版權的文章,請聯系拍明芯城(marketing@iczoom.com)注明“轉載原因”。未經允許私自轉載拍明芯城將保留追究其法律責任的權利。
拍明芯城擁有對此聲明的最終解釋權。




 產品分類
產品分類
























 2012- 2022 拍明芯城ICZOOM.com 版權所有 客服熱線:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版權所有 客服熱線:400-693-8369 (9:00-18:00)


