助力高級光刻技術:存儲和運輸EUV掩模面臨的挑戰
 16
16
 拍明
拍明
原標題:助力高級光刻技術:存儲和運輸EUV掩模面臨的挑戰
在高級光刻技術中,特別是極紫外(EUV)光刻技術的運用,存儲和運輸EUV掩模面臨著多方面的挑戰。以下是對這些挑戰的詳細分析:
一、存儲挑戰
污染風險:
光刻圖案越精細,掩模污染的風險越高。潛在污染源包括外來顆粒和化學殘留物。
掩模涂層比較脆弱,容易損壞,接觸掩模的任何物體都可能造成損壞,如晶圓廠里的機械臂或意外污染物(如人的毛發)。
專用光罩盒的需求:
專為193納米沉浸式光刻設計的光罩盒無法為EUV掩模提供足夠的保護。
EUV光刻的獨特要求使得EUV掩模光罩盒成為一種具有多個關鍵元件且高度專業化的設備。
材料選擇與設計:
接觸或圍繞掩模的所有表面(包括光罩盒的表面)都必須保持超凈,避免引入有害污染物。
內光罩盒通常由金屬制成,避免發生釋氣;外光罩盒可能采用聚合物制成,需考慮其放氣特性。
雙光罩盒配置:
EUV光刻機臺通常采用雙光罩盒配置,包括處于真空條件下的金屬內光罩盒和與周圍環境接觸的外光罩盒。
雙光罩盒配置雖可提供保護,但污染風險仍然存在。
二、運輸挑戰
機械損傷風險:
在運輸過程中,掩模必須承受機械加速和振動,需確保光罩盒能將掩模牢牢固定在原位。
同時,接觸片的阻力不能過大,以免在掩模上造成過多的接觸痕跡。
接觸力與污染:
從顆粒產生的角度來看,接觸力越小越好。接觸點越少,光罩盒引起顆粒污染的可能性就越低。
接觸點的大小同樣重要,接觸面越大,光罩盒關閉時的接觸應力就越小。
材料磨損與壽命:
光罩盒材料的選擇對于盡可能減少接觸痕跡至關重要。理想的光罩盒材料能夠抵抗在固定掩模以及打開和關閉光罩盒時的磨損。
光罩盒的設計使用壽命通常為七到十年,需使用抗磨損材料以延長使用壽命并減少顆粒污染。
氣體交換與凈化:
在運輸和存儲過程中,需定期凈化外光罩盒以除去內部的水分,為掩模保持干潔的環境。
內光罩盒中通常內置有過濾器,用于進行氣體分子的交換,并最大限度減少進入內光罩盒的顆粒。
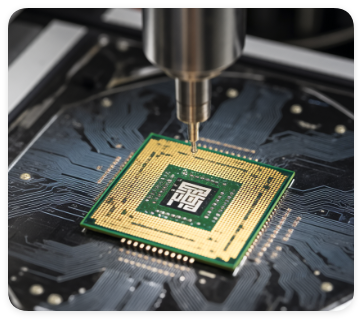
三、綜合挑戰與解決方案
兼容性與設計:
掩模光罩盒的光學窗口必須與自動化設備兼容,以便光刻機中的攝像頭能夠觀察光罩盒內部并正確檢測掩模情況。
現今的光罩盒設計人員應考慮設計兩款光罩盒:一款具有可容納薄膜的空間,另一款可在不添加薄膜的情況下使用。
薄膜保護與壓力控制:
在使用薄膜作為防塵罩時,需確保薄膜的幾何結構與光罩盒的兼容性。
真空凈化和通風會導致內光罩盒中發生壓力變化,必須將此壓差控制在特定閾值以下,以免損壞薄膜。
錯誤識別風險:
EUV設備必須能夠處理帶有或不帶薄膜的掩模,并能區分這兩種掩模之間的區別。
內光罩盒應包含相應設計功能,以確保EUV設備中的攝像頭能掃描并光學檢測出光罩盒類型,降低錯誤識別光罩盒的風險。
綜上所述,存儲和運輸EUV掩模在高級光刻技術中面臨著多方面的挑戰。通過采用專用光罩盒、優化材料選擇與設計、控制接觸力與污染、確保材料磨損與壽命、進行氣體交換與凈化以及考慮兼容性與設計等措施,可以有效應對這些挑戰。
責任編輯:
【免責聲明】
1、本文內容、數據、圖表等來源于網絡引用或其他公開資料,版權歸屬原作者、原發表出處。若版權所有方對本文的引用持有異議,請聯系拍明芯城(marketing@iczoom.com),本方將及時處理。
2、本文的引用僅供讀者交流學習使用,不涉及商業目的。
3、本文內容僅代表作者觀點,拍明芯城不對內容的準確性、可靠性或完整性提供明示或暗示的保證。讀者閱讀本文后做出的決定或行為,是基于自主意愿和獨立判斷做出的,請讀者明確相關結果。
4、如需轉載本方擁有版權的文章,請聯系拍明芯城(marketing@iczoom.com)注明“轉載原因”。未經允許私自轉載拍明芯城將保留追究其法律責任的權利。
拍明芯城擁有對此聲明的最終解釋權。




 產品分類
產品分類
























 2012- 2022 拍明芯城ICZOOM.com 版權所有 客服熱線:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版權所有 客服熱線:400-693-8369 (9:00-18:00)


